半导体硅晶片清洗工艺发展现状
在超大规模集成电路(ULSI)工艺中,晶片清洗的技术及洁净度(cleanliness)是影响晶片成品率(yield)、器件的品质(qualit)及其可靠性(rliability)最重要的因素之一。尤其对于工艺技术发展到0.35μm以下的领域,器件的密度达到数千万至十亿个以上,工艺流程超过数百个步骤,这样紧密、复杂的产品,需要在非常洁净的晶片表面制作。因此,如何清洗晶片,以达到超洁净度的要求,是ULSI半导体工艺中最重要、最严谨的步骤之一。
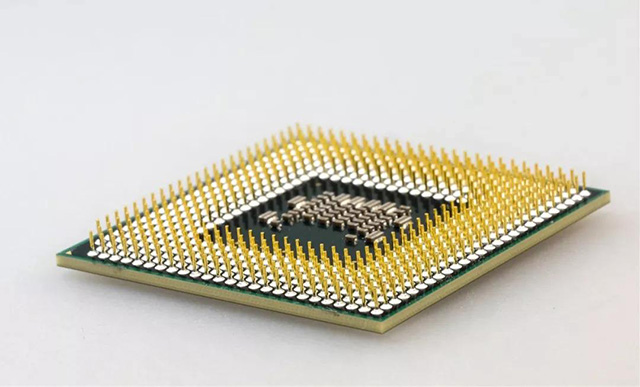
在晶片的清洗过程中,需要用到很多高纯度的化学用品,如用高纯度的去离子纯水(DI water)进行洗涤( rinse),用高纯度的气体(如N2)高速脱水旋干,或用高挥发性的有机溶剂(如异丙醇- IPA)进行除湿干化。晶片的清洗技术,从早期的RCA晶片清洗配方利用高纯度的湿式化学清洗(wetchemicalcleaning)至今,已经沿用了三十多年,并未有太大的改变,只在化学配比(ratio)及清洗顺序(sequence)方面做了细微的修改调整,如将SC1(NH, 0H:H2O2:DI= 1:1:5)的比例稀释到(0.05:1:5)。目前也正在研究、开发先进的清洗工艺技术,如干洗工艺技术和气相清洗工艺以更符合ULSI工艺的需求。
 客服热线:
客服热线: 















