ULSI晶片清洗的要求和规范
清洗的目的主要是清除晶片表面的污染( contamination),如微粒(particle)、有机物(organie)及金属离子( metal ions )等杂质( impurity)。在ULSI工艺中,栅氧化层的(gateoxide)的厚度已低于10nm,还需考虑清洗后,晶片表面的微粗糙度(micro-roughness)及本征氧化物(nativeoid)的消除,以满足半导体器件超薄栅极氧化层(ultra-thingateoxide)的电学参数及特性(electrical parameters and characteristics) ,并符合器件的品质及可靠性。
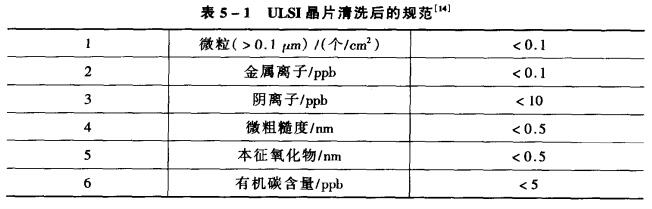
在ULSI工艺中,晶片清洗后的洁净度需达到表5-1所示的规格要求,才能满足深亚微米工艺的要求,并通过电学特性及可靠性测试。
 客服热线:
客服热线: 















